近年来5G、Al、物联网、大数据及智能制造等技术不断突破创新,业内对于体积更轻薄、传输速率更快、功率损耗更小、成本更低的芯片需求大幅提高。
随着先进制程逐渐向原子尺寸逼近,短沟道效应和量子隧穿效应使晶体管的制造难度呈指数级增加。集成电路制程不仅成本整体提升,且在7nm、5nm、3nm制程的量产进度均落后于预期。
先进封装技术登上历史舞台,拓展摩尔定律技术路线。

先进封装主要技术
先进封装是采用键合互联并利用封装基板来实现的封装技术,应用先进的设计思路和集成工艺,对芯片进行封装级重构,并能有效提升系统的高功能密度的封装
主要技术
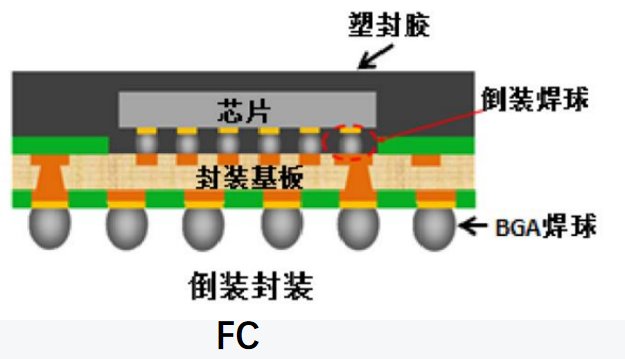
以减少芯片整体尺寸降低芯片厚的倒装
FC(Flip chip)
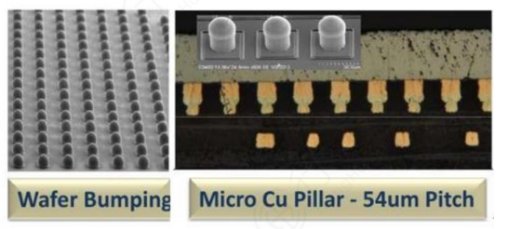
以小球形导电材料实现芯片与基板间电气互联的凸块
Bumping
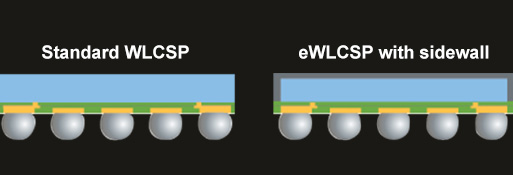
CSP
以减少制造环节和提高生产效率的晶圆级封装
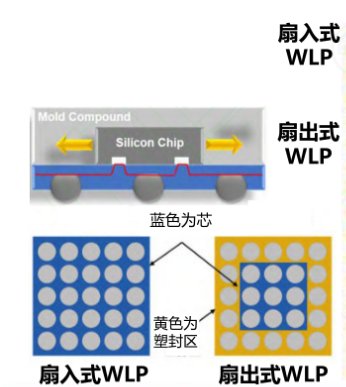
WLP,Waferlevelpackaging
以提高集成度及开发成本的系统级封装

SiP,System In a Package
以实现更精细的线路与空间利用的2.5D封装
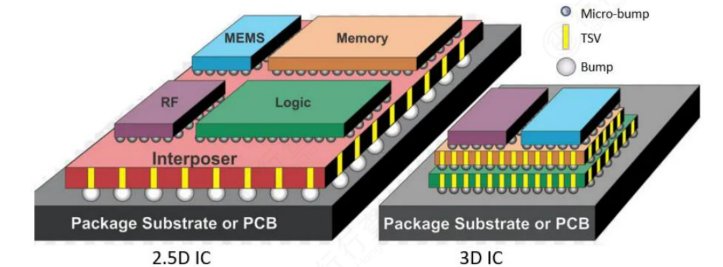
Interposer,RDL等
以提高电路拓展芯片规模和扩展电路功能的多芯片三维立体3D封装等
3D封装
封装内容:2D芯片封装转向3D多芯片封装
互联技术:打线、Bumping、TSV、RDL
封装形式:直插、CSP、BGA、SiP


先进封装依靠卓著的集成优势,为高端逻辑芯片、存储器、射频芯片、图像处理芯片、触控芯片等领域的实际应用带来便利,其主要优点有:
- 封装集成度高、封装体积小;
- 内部连接短,系统性能得到提升;
- 单位体积内集成更多功能单元,有效提升系统功能密度;
- 降低功耗,降低成本;
- 拓展摩尔定律技术路线
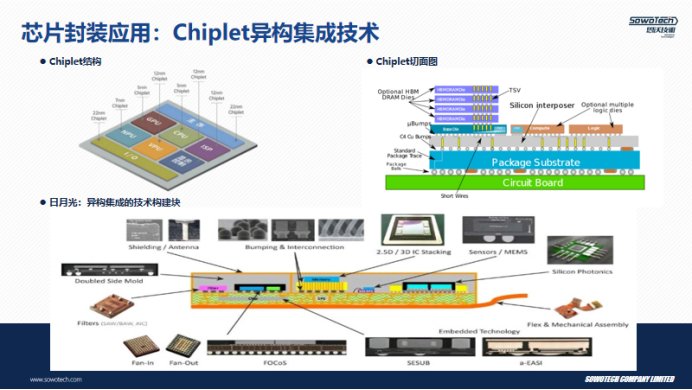
因此,利用先进封装技术,可以将不同尺寸、不同制程、不同材料的芯片集成异构封装,使其在一定的封装面积下获得更快高更性能。即使芯片制造工艺落后,只要掌握先进封装技术,依旧有机会使产品达到高工艺芯片程度,对中国芯片尤为重要,28、14纳米可与7、5纳米芯片同场竞技,解决无芯可用的燃眉之急。
随着半导体行业设计、生产、封测的产业链精细化分工,先进封装与前道后道工艺深度融合。前、后道的头部厂商凭借各自优势入局,成为先进封装行业的主力军,其中,前道主要有台积电、三星、英特尔,后道主要有长电科技、日月光、安靠等。

先进封装在2000年诞生之初只有WLP,2.5D封装和3D封装几种选择,近十年来,代工大厂、IDM厂商与顶级OSAT的鼎力投资竞争下,引领先进封装技术的创新迭代,开发出众多独立命名注册商标,如:
- 台积电的InFO、CoWoS;
- 英特尔Foveros;
- 日月光的FoCoS、FOWLP
- 降低功耗,降低成本;三星X-Cube;
- 华天科技的eSiFO;
- 长电科技FO ECP、XDFOl;
- AMD 3D Chiplet;
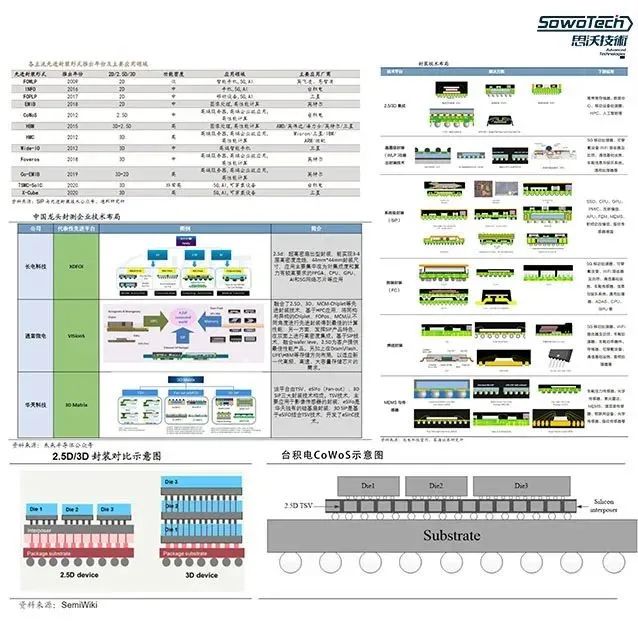
大家都知道整个封装界的升维之路上:从2D封装到2.5D再到3D封装。Chiplet级的封装如果以载体的形式来分则分为两种:晶圆级封装(Wafer level package,WLP)和面板级封装(Panel level package,PLP)。根据载体的材料来分可以归为三类:有机物基板、硅基板、玻璃基板。
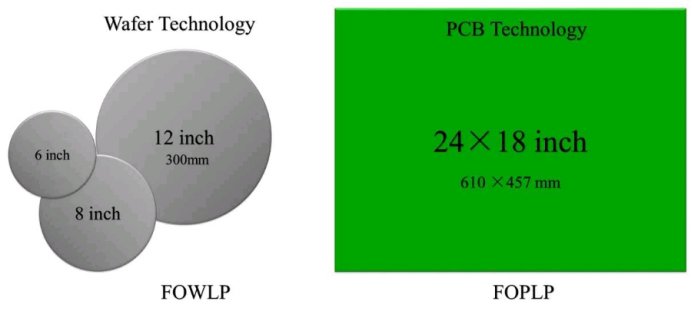
面板级封装的优势主要在于成本。我们将300mm晶圆级封装与515x510mm面板级封NF装相比,可以看到如图六所示,面板级封表心片占用面积比高到93%,而晶圆级封装则只有64%。这几何级别的差异,直接导致生产过程中生产速率UPH的巨大差异。
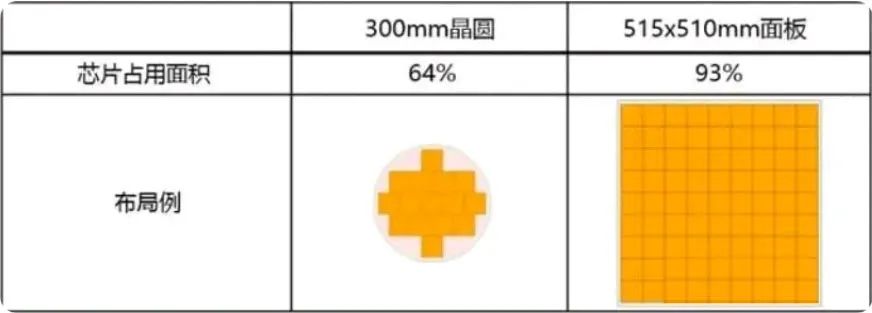
另外,根据Yole报告,例如FOWLP技术面积使用率<85%,FOPLP面积使用率>95%,可以放置更多的芯片数,成本也比FOWLP便宜。具体推算从200mm过渡到300mm大约能节省25%的成本,从300mm过渡到板级,则能节约66%的成本。面板级封装的成本与晶圆级封装相比将会降低66%。
『FOPLP微增层真空贴膜系统』
在晶圆级封装(Wafer level package, WLP)和面板级封装(Panel level package,PLP)在这两个细分领域,国内高端设备却几乎是一片空白,其中真空贴膜系统是做线路增层的核心关键装备,广东思沃先进装备有限公司(以下简称"Sowotech")是国内唯一进入量产阶段卡脖子设备,思沃利用核心技术勇闯半导体无人区。

全球半导体行业的景气度提升及中国半导体行业的高速发展给半导体设备行业带来全新的机遇。
值得注意的是,作为先进封装PLP板级封装环节最核心最关键的真空增层设备却长期依赖进口,这不仅造成下游客户成本高昂,且个性化要求得不到响应。
据Sowotech CEO王建勋表示,该设备在过去一直牢牢地控制在日本Nichigo-Morton这家半导体设备巨头手里, 订货周期需要24个月,可谓奇货可居!即使是半导体一哥台积电也离不开它!被业界称为芯片制造的蓝宝石。

对于龙头封装企业而言,既要考量成本,又要避免核心设备的供应链卡脖子”的安全问题,中小封装企业所承受的成本压力更大。PLP先进制程技术难度很高,整平精度要求接近物理极限。在高温/高压/高真空度复杂物理环境中,极限整平精度要达到0.003mm,产品CPK要做到1.33以上。
立志做半导体行业先进装备隐形冠军
随着中国在先进制造领域实力的增强,性能良好、性价比高、服务接地气的国产设备厂商也迎来了发展的良机。Sowotech就是其中的佼佼者。"以客户为中心,坚持长期主义,作为芯片人我们要有打持久战的战略定力!”王建勋如是说。

Sowotech研发的先进封装用真空贴膜系统V-ONE11产品技术壁垒极高,公司从2016年开始就开始做该产品技术的早期的探索。核心技术涉及机械结构,运动控制,高真空系统环境,油压系统,微空间热管理系统等多交叉学科。在技术攻关方面,先后与东北大学,电子科技大学,华中科技大学建立共同攻关研发团队。王建勋介绍,Sowotech设备整体性能与国际品牌相当。同时结合Al人工智能,边缘计算,有限元素模拟等先进的技术在研发过程的应用,确保了产品的精度与系统的稳定性。

当前的复杂形势下,集成电路行业,尤其是先进装备与材料国产化进程刻不容缓。作为一家深耕行业14年的民营企业,解决我国核心装备的卡脖子问题是责无旁贷的责任。牢记使命,不忘初心,为客户,为行业,为国家,创造最好的智能装备。
来源:思沃技术


