智能手机是高附加值产品,它对微型化有非常高的要求。客户期待更大的屏幕、高分辨率的内置相机、以及更轻薄具备更多功能的手机。2017年,Apple公司要求组装服务商为手机配备一种新型“电路板”,一种类似载板的PCB(SLP)。因此导致了PCB制造商的技术转移,及对改良半加成工艺(mSAP)的投资需求。该领域也吸引了新的竞争者——开创了mSAP技术的IC载板制造商。 因此,苹果的SLP供应商资本投入都非常大。紧接着,Samsung公司于2018年初推出的Galaxy S9手机也采用了SLP技术,一些韩国的PCB制造商也进行了类似的高资本投入。此外,更多的PCB及IC载板制造商虽然不是Apple和Samsung的供应商,也加入了竞争行列。 SLP的采用始于2017年后半年,预计到2023年,产量将从2017年的2700万单元上升到4.4亿单元,年复合增长率将达到59.4%。经调查分析,2017年SLP带来的收入预计为1.9亿美元,2018年将上升至14亿美元,到2023年将上升至22亿美元,年复合增长率将达到51%。 减小手机用PCB的特征尺寸是为了让智能手机变得更薄功能更强。由于需要增加越来越多的功能,以及配备越来越大的屏幕,功耗就成为了关键点。在智能手机中,电池占据了大部分空间。随着电路板上特征尺寸的减小,需在固定的面积里实现更多的集成。如图1所示,从iPhone 5s开始,与智能手机总面积相比,苹果iPhone手机PCB面积占比逐渐减少。直到最新的iPhone X系列,面积占比已经减少了3%,功能却增加了,电池的容量也增加了。与此同时,iPhone X不仅采用了SLP,而且还将两个SLP堆叠了起来,以进一步增加在固定面积内的集成。 增加密度、减少互连可实现表面积的减少。 图1:苹果旗舰智能手机的PCB分析 半导体工业的发展趋势正在影响着半导体封装及与电路板的互连。过去,PCB用来实现芯片和最终产品的互连,但现在成为了集成方案。SLP是当今满足大规模需求的解决方案之一,同时也是对功能发展路线图的积极响应。 因为现在的“电路板”已经模糊了PCB与IC载板之间的定义,SLP因此而得名。尽管PCB与IC载板是通过不同技术制造的,但其实它们之间的主要区别是特征尺寸,特别是线宽和线距(L/S)。过去,一块PCB甚至是HDI板的特征尺寸都要大于30/30μm;一块IC载板的特征尺寸常常大于15/15μm。然而,SLP的特征尺寸已经小于30/30 μm,虽然它是一块PCB,但它的特征尺寸已经非常接近IC载板了,SLP因此得名。 过去,PCB是用减成工艺制成的,蚀刻是在已预先存在的铜箔层压板(厚度> 5μm)上完成的。因此常常会导致过蚀,之后还不能补偿。因此,采用减成工艺的最小L/S是有限的。 与减成工艺不同,mSAP采用负图形设计“生成”铜,即在预备好的薄铜箔上电镀(厚度<5μm,只作为种子层)。然后蚀刻掉负图形。mSAP通常用于制造IC载板,允许L/S特征尺寸进一步微型化。直到现在,一些型号的智能手机虽然已经采用了SLP,L/S仍为30/30 mm。但是,采用mSAP制造电路板后,进一步减小了L/S,增加了集成。采用mSAP制造电路板仍存在一些挑战;目前的SLP不是完全通过mSAP工艺制造出来的,而是采用减成工艺和mSAP(图2)混合制造的。正在进行进一步的研究和开发,以控制其制造工艺,同时进一步减小特征尺寸。 图2给出了先进载板技术所能达到的技术特征。如图中所示,过去用于不同制造阶段的技术开始重叠。目前,SLP对于用于电路板制造的封装技术给了一个很好的实例。在未来,其他技术也将会重叠,将会在半导体工业产生潜在的新竞争领域。 图2:先进载板技术 尽管只有两大智能手机制造商在其旗舰手机中采用了SLP,但预计,其他大型智能手机制造商如华为、小米和Vivo在未来几年内也会顺应这一发展趋势。智能手机制造商将继续在有限的电路板面积内增加集成的趋势,以增加功能或为额外的电池容量提供空间。其他需要不断小型化的产品,如可穿戴产品、平板电脑和笔记本电脑,很可能是下一类采用SLP的产品。 SLP是当今规模及功能需求的解决方案之一,但很快会出现更多需要解决的需求。与过去相比,先进载板市场将会发生巨大的变化(图3)。电路板特征尺寸的不断减小及SLP的采用将会使传统PCB市场缩减。高密度扇出(HDFO)技术的发展及IC载板尺寸的不断减小也会减少载板的市场,尽管在数量上,市场可能会缓慢增加,但先进载板的附加值将会继续增加。 图3:先进载板市场的发展 今天,对尺寸和功能的需求强烈地影响着半导体封装技术,并引发了PCB的变革。PCB已不再是只实现简单的互连,现已发展成了封装的一部分。YOLE高端载板项目将继续研究这种发展趋势,并提供更多的市场分析。 本文所有插图均来自Yole Développement于2018年2月发布的报告——《先进基板状况:嵌入晶片与互连、类载板PCB的发展趋势》。
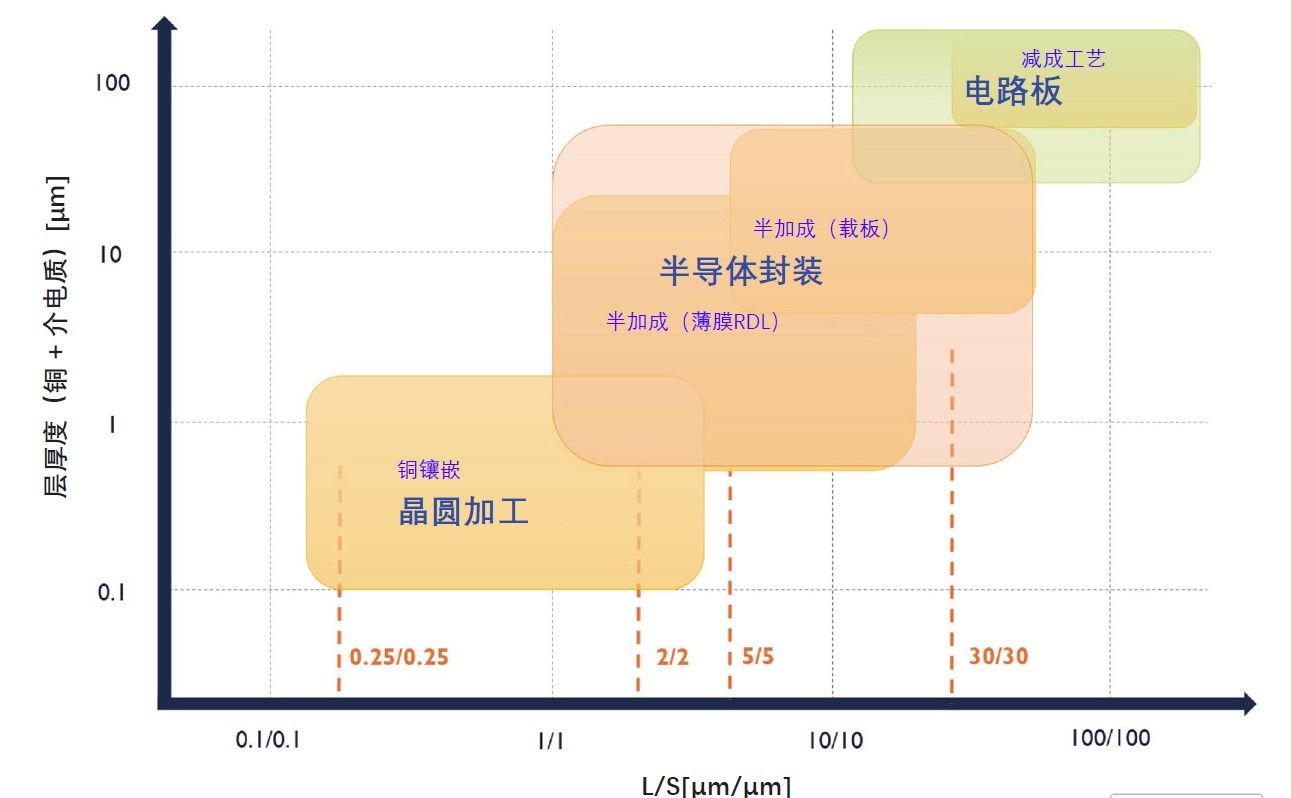

更多内容在线查看。
作者:Emilie Jolivet是Yole 集团Yole Développement公司半导体与软件分部的主管,她主要负责封装和组装、半导体制造、内存、软件及计算领域。


