随着5G的发展以及AI广泛应用于日常生活,整个半导体行业和印制电路板的新技术开发被不断地推向更高的水平,特别是将高密度互联制造应用于小型化、高级封装和高性能这三个平台。其中,推动技术革新的引擎之一就是移动设备小型化,而这需要通过细线路制造来满足设计要求。但是,在细线路的电镀上,铜厚均匀性一直是一个持续的挑战。除此之外,用于类载板PCB(SLP)的改良型半加成法制程(mSAP)和IC载板的半加成法制程(SAP)的铜电镀工艺,还必须同时满足盲孔的填充。因此,杜邦研发团队致力于持续开发创新的铜电镀添加剂,以实现良好的图形均匀性于电化学铜沉积,并且保证稳定的填充盲孔表现,满足类载板PCB (SLP)和IC载板未来的市场需求。
具备优良稳定的填孔能力以及图形均匀性表现
铜电镀液主要包括无机和有机两大类组分。无机组分包括铜硫酸盐、硫酸、和氯离子;有机添加剂主要由光亮剂(Brightener)、载运剂(Carrier)和整平剂(Leveler)组成。光亮剂通常是含硫小分子,作为加速电镀剂,光亮剂扩散到盲孔内部并加速盲孔底部的铜沉积生长;载运剂为大分子量的聚合物,吸附在铜表面,减少电镀铜在表面的沉积速率;整平剂则通常是含氮的带电聚合物,通过吸附在高电流密度区域(如盲孔口尖角位置)来有效抑制该位置电镀铜的沉积速率,防止包芯产生,达到填孔及平整表面的效果。有机添加剂协同作用于包括铜表面、盲孔内等不同绘图区域,通过差异化的抑制效果来实现无包芯填孔,以及达到优异的图形均匀性。杜邦公司提供两种不同电镀药水MicrofillTM LVF-VI及MicrofillTM SFP-II,运用于mSAP以及SAP工艺制程。 在图形电镀中,图形设计的不同造成电流分布差异极大,增加了电镀的难度,进而导致整体图形均匀性不佳。杜邦研发团队通过系统化的实验设计,搭配COMSOL Multiphysics作为多维度数值模拟不同图形之间的电流分布,以及铜离子浓度在电镀过程中受电场和流场影响下的传质状态(图一),成功开发了具有最优化的添加剂选择及浓度,大幅改善图形电镀均匀性不佳的问题,特别是发现降低氯离子浓度可以有效减少氯离子及载运剂在细线路的抑制作用,使其不易扩散进入细线路区域,借此通过提高超细线路区(10/10µm)的镀厚,满足未来细线路金属化的市场需求(图二)。
.jpg)
图一 数值模拟示意图
.jpg)
图二 新型电镀添加剂机理
适用于盲孔、X型孔的多变化应用
研发测试结果显示开发的新型药水,可满足不同特征的填孔需求,包括盲孔以及X型孔填孔。图三显示了在孔径65μm~90μm下的盲孔上以及在不同规格的X型孔上,皆可展现出稳定的填孔表现,无包芯及漏填等缺陷。
.jpg)
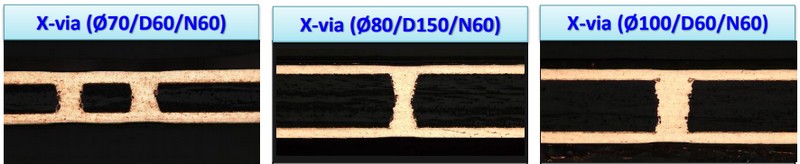
图三 不同特征下皆有稳定的填孔表现
均匀分布的沉积铜晶粒大小有利于抗蚀刻表现
mSAP制程的另一个大挑战是针孔缺陷(Pitting)。在快速蚀刻步骤产生的针孔会严重影响最终产品的可靠性,新型电镀添加剂的开发目标是可以被均匀蚀刻的电镀铜,同时保持优异的填孔能力和精细的细线路解析度。
杜邦研发团队通过扫描电镜(SEM)及电子背散射衍射(Electron Backscatter Diffraction,EBSD)的方法来研究电镀铜沉积的晶格结构,找出影响针孔形成的主要因素,并开发出相较于传统添加剂具有较均匀分布的沉积结晶大小(图四),有助于抗蚀刻的表现,减少针孔的形成,大幅提升产品可靠性。
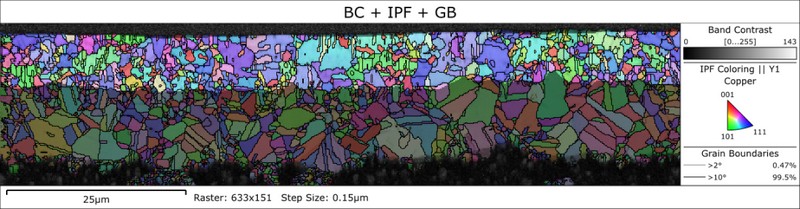
图四 新型电镀添加剂铜沉积结构EBSD结果
来源:杜邦公司


