NextGIn Technology公司的Joan Tourné和沪士电子的Joe Dickson概述了垂直导体结构(VeCS)及其优点,它将如何改变设计,为实现这种结构需要考虑的因素,及其目前可靠性测试数据的情况。
Nolan Johnson:谢谢你们接受采访。首先,二位可以介绍一下你们在各自公司的职责吗?
Joe Dickson:我在亚洲先进PCB制造商沪士电子WUS工作。我们于三年前开始研究VeCS技术,开发了许多制造方法并进行了优化,致力于挖掘最佳实践方法。目前研究仍在继续深入,希望这项技术在常规HDI导通孔和通孔方面有突破性发展。
Joan Tourné:我是NextGIn Technology公司的创始人。我们的目标是为行业提供不同的解决方案,VeCS正是其中之一。我们正在与一家设备供应商合作测试一种新的背钻和检测方法,力求让制造更轻松。目前行业所实施的部分工艺过于复杂,且依赖于人手工操作,这并不是设计的初衷。我们想要改变的,不让操作员控制工艺的设置。这就是NextGIn的基本理念。
Johnson:VeCS引起了HDI领域专业人士的关注。例如,Happy Holden对你们正在做的工作非常兴奋。什么是VeCS?
Tourné:VeCS是Z轴互连技术,我们的真正重点是如何实现层到层的过渡,以及PCB或半导体封装的功能。该理念是利用PCB行业可用的工艺和设备,在无需建立新工厂或开发新设备的情况下,能否在制造新产品或新技术方面另辟蹊径?采用一种不同的方法来实现Z轴连接是一种理念,通过这种方法,我们克服了因顺序层压带来的限制问题。
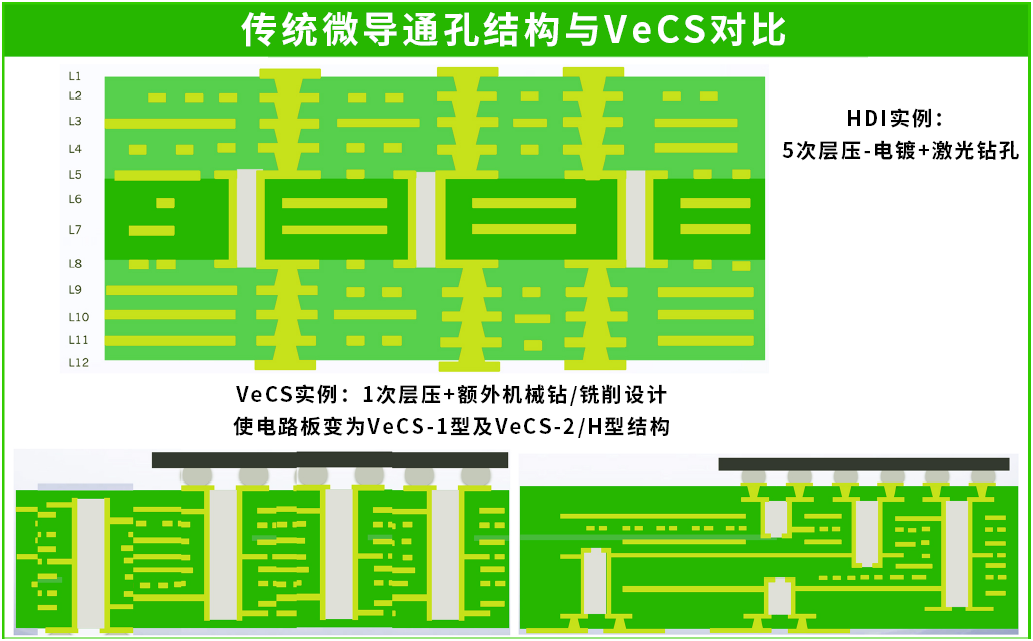
我在上世纪90年代初把微导通孔引入了这个行业,在欧洲购买了第一台激光钻孔设备。即使在那个时候,激光钻孔也在与等离子蚀刻和光界定介质抗衡。等离子蚀刻和光界定介质是一种很简单的技术,可以在10分钟内钻100万个孔;而激光在那个阶段一分钟只能钻几百个孔。最终,具有高可靠性的激光钻孔打赢了这场战役。这就是为什么现在每家工厂都在用激光设备钻孔。而VeCS理念是利用微机械加工技术以不同的方式实现Z轴连接。
我们要物尽所能所有可用的材料。我们不想受材料限制,同时简化电镀工艺,因为电镀生产线在电镀高厚径比的导通孔时非常复杂,存在很多限制,无法做盲孔;这也是我们想用VeCS解决的问题。希望在不需要非常复杂顺序积层的情况下即可实现连接。我们想创建一种可以在PCB上实现深度很深的盲孔电镀连接的技术。
通常情况下,只能电镀厚径比最大为1:1的盲孔。有了VeCS技术,我们可以很容易地达到10:1甚至20:1的盲孔,具体取决于槽的长宽比。同时,如果看时域仿真结果,导通孔的孔问题是,它非常具有电容性。我们希望可以调整其阻抗的垂直连接,其阻抗与走线宽度的阻抗一样,不会反射。我们就会得到比普通电镀通孔更高性能的电路。
Barry Matties:这项技术的目标是什么——可靠性还是成本,或者其他?
Tourné:VeCS技术的目标是可制造性。我们看到手机采用了很多微导通孔HDI技术。但在数据通信运算领域,其电路板都非常厚,高达3毫米甚至更厚。这确实是我从业界得到的反馈,包括Joe Dickson先生也表示“如何为未来的电路设置默认值呢?我们能加工3-5毫米的HDI电路板吗”?这种要求很难实现。OEM向更小间距封装的发展受到了限制,且应用困难。很难就0.5mm间距的封装要求来生产PCB,这项技术至少到目前为止还不成熟。
即使是出于趋肤效应的原因,也必须加宽内层走线布线。根据经验法则,如果75微米介质层,就无法加宽走线布线。为了实现50欧姆阻抗或100欧姆差分阻抗的匹配,要使走线宽度与介电厚度接近相同。对于高速电路,HDI技术存在物理限制,这是开发VeCS技术的原因之一。
从那时起,我们就开始考虑能做些什么。以前Joe在Cisco Systems公司工作时,我们尝试了很多方法,比如围绕着使孔分开和做其他类型的电路开拓思路。经过这么多年这些想法又被再次提出,并发展成为一种新的电路技术。
Matties:有趣的是,你们明确了这项技术对应设备的一些控制界限。为了实施这项技术,制造商需要做哪些改进或投资?
Tourné:一台极佳的数控铣削机。现在市场上有专为VeCS技术开发的铣削机,具有光学对准,可满足图形与图形的对准,以及远远超过100K RPM的主轴。铣削越有效,槽的质量及工艺速度都将提高。除此之外,还需要具备先进的真空导通孔填充或槽填充能力。
现在大多数工厂采用了这项技术,已有设备在市场上出售。从工艺角度来看,采用了目前使用的相同技术,但有一些修改。就顺序而言,该工艺有所不同,但差别不大。这是众所周知的方法,不涉及新材料、新工艺或新技术,只是顺序不同而已。
Johnson:这是否意味着可以在同一条生产线上同时运行传统的制造工艺和VeCS工艺?只是不同的产品采用不同的顺序来生产?
Tourné:首先铣槽,在同一阶段钻BGA的间距,然后电镀,再将槽填满。如果外层图形非常密,我们可以同时做微导通孔。对于我们经常谈论的超细BGA间距,要保持它的清洁,并在VeCS槽顶部采使用微导通孔。
Dickson:制造能力在不断发展。三年前,对于VeCS-1槽我们使用10年前的铣削设备和非真空填充微导通孔,能够采用传统技术通过背铣槽相当容易地实现VeCS-1槽,但客户不断提出更多要求。现在,我们已可以控制高阶盲VeCS。目前可以做多种深度的盲槽。我们努力消除VeCS所需专用设备的界限。比如CCD对准铣削设备,对于PCB行业来说是相当新的。我们现在有高真空导通孔填充设备,可以挤压表面,甚至对于非常深的盲槽也可形成平整的树脂表面。
现在有比刚开始实施VeCS技术时更先进的设备。我们可以用这两种设备来制造产品,且新设备的可靠性和可控制性比过去要好得多。我们正在生产的一些结构不仅仅采用VeCS技术。在最简单的形式中,VeCS是一种互连技术。它可在1个切口中创建2个导通孔,具有非常密集的布线能力。而且它还有能力匹配信号在Z轴X平面和Y平面上的阻抗。对于较厚的电路板,当运行时域仿真分析时,可以看到阻抗在整个互连中都是匹配的。
这是VeCS真正的价值所在,可能除了HDI外,他们希望看到在其他地方使用VeCS和某种类型的通孔结构,比如在BGA或其他区域。VeCS以及HDI通孔导通孔将可实现高阶SI、高可靠性和高性能的互连。
Matties:这个过程设计如何介入?他们是否需要经历新的学习过程,或者这是一项直观易学的技术?
Dickson:可能需要经过最长的学习周期。我们竭力帮助设计师进入VeCS设计阶段;在只能进行堆叠HDI布线或通孔的限制之间,存在着一种模式转换。3年前,还没有可用的软件和工具。现在,大多数主要的设计工具都可以采用VeCS进行设计,且这是真正的模式转换。有能力采用这项技术的设计师正在展示Joan和我可能从未想过的概念性理念。前几天我看到过一个设计案例,底部的VeCS作为VeCS-2盲通孔的背面连接,VeCS顶部还有HDI。他们正在考虑将0.3毫米间距的BGA互连到没有载板中介层的PCB内。启动之初,我真的并没有想到这一点。但是,能够如此深入并形成如此密集互连的能力,对他们来说必定还有很多机会。
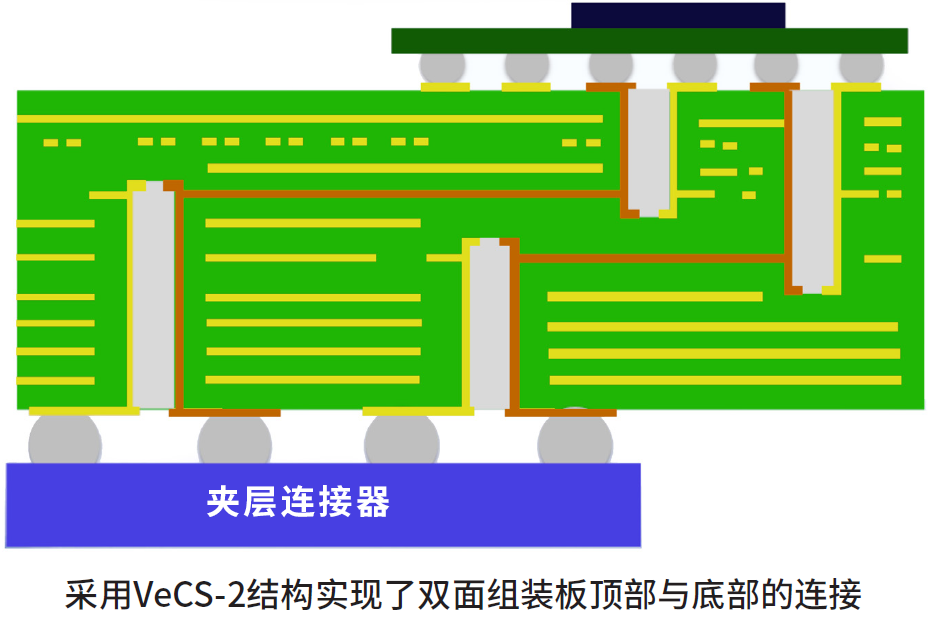
Matties:对于一家采用这项技术的公司来说可谓打开了新的市场机会,掌握了这项前沿技术将有很大的优势。
Dickson:我们已经达成共识,即必须自己设计测试载体。几乎每次我们为OEM做功能测试或演示测试时,都要签署保密协议。无论是HDI还是通孔都无法实现屏蔽,这项技术可以从三个侧面完全屏蔽RF信号。当OEM发现可以实现屏蔽时,立刻明确说:“你们不能发表这篇文章,这是我们知识产权的一部分。”我们必须在内部开发自己的测试载体和演示视频,以便和客户沟通,有了IP,就可以做很多选择。
Tourné:不仅仅是满足技术要求,最近有客户想要更快的交付期。他们不想为一个产品做6次到7次层压,因为这样会大大延长交付期。是否能只做一次层压,采用VeCS技术和单次层压来加快工艺速度,相比HDI技术生产相同的产品,需要6次层压。
Matties:与传统HDI相比,你们真的把生产周期缩短了很多?
Tourné:我们现在还没有大范围地进行批量生产,但激光钻孔速度更快。整个周期包括成像、电镀、再成像、重复六次,而不是一次;层压周期也需要时间。我们最终帮客户解决了问题。总的来说,生产周期会缩短。单从铣削这一步来看,比较慢。
Matties:加上在电路板上施加的所有热应力,再加上多个层压周期。
Tourné:层压步骤会使材料老化,意味着材料寿命更短。
Dickson:这项技术和行业目前所处的状况非常吻合。而且对于结构本身,我们已经做了足够的工作,且已经向行业展示了一些VeCS-1的图形实例。现在对互连结构本身进行了可靠性测试,一旦填充和封装后,它会非常可靠,有可能超越传统的通孔。我们正在建模、模拟VeCS,验证它的可靠性为什么如此高,将会撰写相关主题论文。VeCS的可靠性高主要是因为电镀形成的互连更像是走线,而不是环形导通孔,连接上的应力更小。最薄弱的区域是VeCS走线,因此只有在达到最大延伸率后才会失效,类似于导通孔。
它的应力来源于树脂周围走线的膨胀,这使得电路板内部的互连几乎无应力。我们已经做了20个回流焊周期,但互连并未断开。我们会把电路板拆开然后破坏它,导通孔仍是连接的。我们都知道低应力的互连很好。现在已经能够制造出会失效的结构,也能够制造出稳健的结构。当然,这与HDI的发展很相似。WUS公司将有显著的优势,因为我们已经看到了如果不采用VeCS,互连技术已发展到尽头。
也许Joan很清楚可靠性之高,但我并没有意识到会如此之高,没有意识到它的表现至少和通孔一样好或者更好。HDI堆叠导通孔是潜在风险,因为导通孔与其周围介质之间的CTE不匹配。在槽的两侧VeCS电路的表面存在X轴/Y轴 CTE膨胀,但几乎相同。这点让我很惊讶,虽然没看到实物,但有图片为证。
由于篇幅有限,本文节选刊登,更多内容可点击此处在线阅读,本文发表于《PCB007中国线上杂志》12月号,更多精彩原创内容,欢迎关注“PCB007中文线上杂志”公众号。

标签:
#制造工艺与管理
#VeCS
#NextGIn
#沪士电子
#新技术