2020年上半年,FC-BGA载板比去年同期增长了30%,预计在未来几年内,随着封装设计需求量的不断增加、复杂度的不断提高,FC-CSP的市场也会持续增加。服务器、存储器、5G网络基础设施等市场的增长和各类AI技术的加速发展,再加上越来越多的人选择在芯片设计中采用异构集成技术,会促使封装变得越来越复杂。
异构集成技术将不同元件或芯片组合在载板上,可满足人们对低功耗、低延迟和实时数据处理的需求。移动电子产品内系统级封装(SiP)取得的成功就是个很好的案例。这类设计可以减少功耗、增强处理能力,使当前5G技术支持的智能手机和IoT设备能够正常运行。随着5G技术及工业 4.0自动化技术的不断发展,5G智能手机和IoT设备也会出现增长。
所有这些技术对布线密度的要求不断增加,目前的有机载板制造商正在使用一系列高阶金属化技术生成接近晶圆级封装的线宽/线距。
本文将概览这些在IC载板上形成精细线宽和线距的金属化工艺。主要涉及IC载板初级金属化工艺中的电路形成、初始材料及半加成工艺(SAP)所采使用的关键技术。还会讨论RDL使用的电镀技术、无芯材载板以及热量管理,用于大面积面板级封装载板的电镀设备,以及针对电路分辨率的各向异性最终蚀刻工艺等。
初始铜箔厚度或不使用铜箔
高端封装的晶片尺寸一般较大(200 m㎡+),有很多I/O(1000至10000个),也可以与其他晶片或器件组合在同一块载板上。这些系统的布线要求包括极高的电路密度、超细线宽/线距,需要一层或多层重新布线层。与PCB使用的HDI正相反,IC载板制造过程中使用的高密度电路在初始载板上会使用极薄的铜箔或者不用铜箔。图1对比展示了PCB制造过程中和IC载板制造过程所采用的不同HDI生产技术使用的初始铜箔厚度趋势。
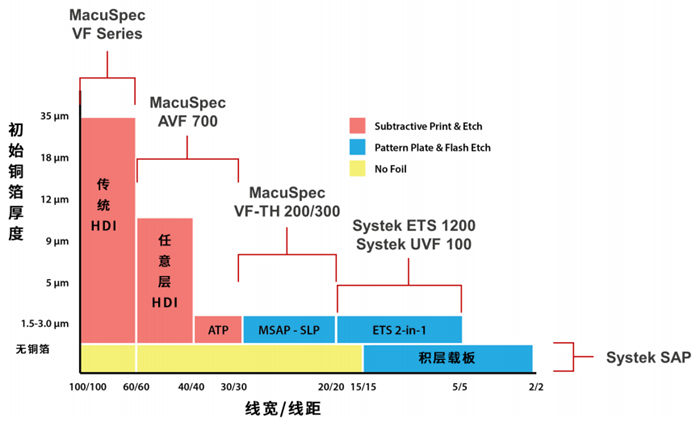
图1:各类高阶PCB制造应用和相关商用金属化工艺中初始铜箔厚度与线宽/线距尺寸的对比图
SAP vs. mSAP
为满足最高密度中介层的电气布线需求,SAP利用化学镀铜技术来生成初始晶种层。采用改良半加成工艺(mSAP)在薄铜箔层压板上实现密度相对较低的IC载板设计(以及超高密度的PCB,例如手机用PCB)。
SAP技术可以直接在有机层压载板材料上制成最精细的线宽/线距结构。工艺流程始于有机积层裸材,例如ABF,这类材料已经层压在了上一层或核芯层。激光钻微导通孔之后,对载板进行去钻污,然后用一层薄的化学镀铜晶种层进行金属化,再图形电镀在铜功能层上形成所要求的铜,然后蚀刻去除多余的电镀表面铜层和初始晶种层。
SAP技术可以形成10/10 µm的线宽/线距。mSAP技术目前应用于30/30 µm线宽/线距的大规模生产中。该工艺使用传统半固化片和超薄铜箔(~3 µm)制成初始载板。采用激光钻出微导通孔之后,给面板去钻污,然后经过初级金属化工艺——例如化学镀铜或碳直接金属化工艺,再成像、图形电镀、蚀刻至特征之间的层压板。
两种工艺都采用了各向异性的最终蚀刻法,这种方法优先快速蚀刻位置较低区域的铜,蚀刻位置较高区域的蚀刻速度较慢,即在清理及界定走线之间的间距时,可限制从走线和其他特征上移除的表面铜量。与mSAP相比 ,SAP之所以能制成更细的线宽和线距,主要是因为镀铜的加成步骤更少,形成高分辨率的电镀图形所需的蚀刻更少。图2列出了两项工艺的主要差别。
图2:SAP可以在IC基板RDL上制造出更细的线宽和线距
SAP:初级金属化技术的主要考虑因素
SAP是经生产验证的工艺,可以通过化学镀铜直接在聚合物树脂上金属化积层介质层。不再采用减成法蚀刻去除铜箔的优势在于,能形成更细的线宽/线距和更小的焊盘,可满足IC载板的要求。随着人们不断研发10/10 µm以下的线宽/线距,12/12 µm线宽/线距的良率已明显提高。
SAP化学镀铜金属化工艺与刚性及挠性PCB的传统金属化工艺类似,工艺流程为去钻污,然后再进行表面预处理和活化,最后形成一个厚度在0.7µm至1.0 µm之间的化学镀铜晶种层。化学镀铜的晶种层一定要具备足够的附着力,才能粘附在有机积层材料和盲孔目标焊盘上。这样是为了在电解电镀电路时提供相应支持,以及在组装和回流焊过程中能承受热机械应力。图3所示是SAP工艺铜与树脂的界面。
图3:对于半加成晶种层的性能而言,树脂和铜界面 的铜层附着力是一个至关重要的指标
制备化学镀铜附着的载板要求同时具备化学附着力和机械附着力。高锰酸盐去钻污化学物质可用于氧化环氧树脂表面,增强亲水性。随着引脚数量密度的增加,走线宽度和焊盘面积的不断减小,以适应扇出需求。
密度要求再加上信号速度加快,意味着在去钻污过程中晶种层和介质之间的附着力不能明显粗化积层材料是SAP技术必须具备的属性之一。积层介质可用的环氧树脂、玻璃珠或玻璃纤维多种多样,成为了SAP技术的挑战。像 Systek SAP 这样的去钻污工艺已经出现在商用市场,可以在低于规范粗糙度的同时与多种常用载板兼容(图3)。
图4:对于载板电气性能,载板材料的粗糙度在规定的要求以下是非常理想的属性
为了增强树脂表面的化学粘合,Systek SAP还在去钻污后加入了保护步骤,给树脂表面添加了官能基,然后再使用一般的阳离子调节剂。下一步是利用钯离子催化剂和退黏剂溶液来活化表面。Systek SAP Copper 850可以电镀化学镀铜晶种层,该工艺使用了优化配方,在初始内部应力几乎为0的前提下可以承受高达30000 psi的抗拉强度,延伸率也能保持在10%至14%之间。
SAP工艺中化学镀铜的均镀能力需要十分出色,才能在整个微导通孔结构中保持涂层均匀。图5所示是Systek SAP外加Systek Copper 850工艺后得到的导通孔结构,载板表面和导通孔目标盘的铜层厚度,以及使用Systek UVF 100电镀之后再进行的填充。
图5:若想获得可靠的导通孔填充,SAP晶种层镀覆的涂层必须要均匀
通过电解镀厚度最小为30 µm的电解铜层,再使用Instron Universal Testing System从介质表面剥离,测量剥离强度。受测的3种积层薄膜的剥离强度都超出了客户的目标。
研发团队现在针对可行性项目,已经研发出可以用于制造1 µm至2 µm线宽/线距的前沿高阶SAP工艺。这一高阶金属化工艺使用非甲醛溶液进行化学镀铜和电解闪镀,可使最终蚀刻后的侧蚀最小化。
图6:使用SAP工艺镀多种ABF基板后铜层的剥离强度
RDL的电解镀铜
IC载板中封装布线最常见的电镀结构类型是重分布层(RDL),这种结构能够形成水平轴和垂直轴的互连,从而可重新定位集成电路的I/O焊盘。RDL可用于在异构设计中与其他元器件形成连接,实现在扇出封装等结构中更密集地布置引脚和中介层布线。
在采用前沿技术时,电镀化学物质可以在填充纵向导通孔的同时电镀后续板层较细的走线,整个过程只需一步就能完成。不论是在使用SAP工艺制造的载板上,还是在mSAP 和高阶盖孔工艺(ATP)中使用的超薄金属箔载板,这类工艺都能形成尺寸精密的电解铜层,而且是高阶封装的支持技术。图7所示为芯片封装示意图中RDL镀层的位置。
图7:在二合一导通孔填充中形成的RDL特征,精细特征镀层实现了有机载板积层
RDL导通孔填充铜镀液中,铜离子的浓度很高(高达250 g/L),而硫酸的浓度较低(50 g/L),其中还有润湿剂(或载运剂)、增亮剂和整平剂以促进快速填充。这些添加剂共同作用,控制电镀速率、沉积层平整度以及整个铜层的物理性质。增亮剂用于加速电镀沉积。润湿剂是高分子量聚氧化烯化合物,可通过与氯离子作用吸附在铜层表面,抑制电镀。整平剂通过增加扩散层的厚度,抑制电镀速率。
通过这些综合反应的作用,这些化学添加剂可以在阴极表面的多个位置改变其电气性质,因为随着从底部往上填充导通孔,等表面变得均匀时就会使镀层平整。这种情况叫做曲率提升加速剂覆盖率(图8)。
图8:由下往上填充导通孔的过程中,润湿剂、增亮剂和整平剂的相互作用形成了曲率完善加速剂覆盖
可针对不同电镀方法优化导通孔铜填充添加剂。在任意层的电镀过程中,都要为表面铜的高抑制而配制载运剂。电镀工艺就是全板电镀,所以几乎不存在表面电流密度差异。导通孔填充厚度可达10 µm,跟表面铜层的厚度一致。这是在高级盖孔工艺中采用超薄mSAP金属箔和盖孔-蚀刻的优势。
可为图形电镀优化RDL导通孔填充添加剂。运载体剂分子的设计用于改善图形电镀的垂直度,使形成圆顶的可能降至最低。不论是精细走线,还是焊盘区域,RDL电镀的目标都是使让导体高度均匀。图9所示的面板采用Systek UVF-100进行了图形电镀,上面有128个特征(32 mm x 45 mm的部件),导通孔宽60 µm、深30 µm,线宽/线距是18/25 µm,使用VCP电镀工具在1.94ASD(18ASF)条件下电镀50分钟。
图9:采用Systek UVF 100图形电镀IC基板RDL
对于IC载板制造商而言,RDL电镀液是一种多用途工艺。该工艺主要使用垂直连续电镀装置(VCP),用垂直分布器上安装的迷你喷射器直接产生撞击。撞击步骤有助于微导通孔中的溶液置换,在缩短电镀时间的同时增强了镀层均匀性。同样的RDL电镀液可以用于电镀各种直径和深度的导通孔,同时可以在不需要调整化学组成的前提下电镀芯材中的贯穿导通孔。图10所示是Systek UVF 100电镀的双射激光钻孔、金属化和图形电镀的芯材。为了简化工艺流程,重要的是在不同尺寸走线之间保持统一的高度,而且填充后的导通孔上凹陷最浅。
图10:最终蚀刻前,用Systek UVF 100成像电镀的双射激光钻孔芯材

标签:
#制造工艺与管理
#麦德美爱法
#异构集成
#高阶封装载板
#金属化