半导体发展路线图历史
半导体行业的大多数人都熟知国际半导体技术发展路线图(International Technology Roadmap for Semiconductors,简称ITRS),从1991年开始(作为半导体国家技术路线图)它一直为半导体行业的发展提供指南。由于摩尔定律的优势越来越难以实现,成本也越来越高,该组织决定2016版路线图为最终版本。接力棒交给了异构集成路线图(HIR),人们逐渐认识到,异构集成是组装不同类型的器件,而不是整体制造,是半导体行业持续发展的重要推动因素[1]
半导体行业的航空航天和国防领域对技术、安全、供应链和生命周期有着特有的需求。异构集成是一项使所有这些挑战相交在一起的关键技术,因此HIR组织将航空航天与国防(aerospace and defense,简称A&D)确定为主题之一,专门针对其特有需求设立一章和相应的技术工作组(technical working group ,简称TWG)。HIR确定今后5年、10年和15年之内发展的挑战,提供了如何应对这些挑战的指南。当然,这是一项持续不断的工作,需要根据技术能力的发展和新需求的出现不断更新。
初始范围
2019年出版的A&D章节初始版本主要关注了美国航空航天和国防领域面临的挑战和要求。HIR旨在为全世界半导体行业创建可提供实用指南的文件,因此以美国为中心的观点应该被视为这项工作的起点。当然,在整个国际A&D领域,存在着许多普遍存在的技术挑战,例如可靠性、带宽、热量管理、辐射硬化、长产
品开发周期和寿命以及供应链安全性,因此许多内容可以概括为涉及了美国航空航天和国防工业以外的领域。本章今后的修订将反映更广泛的范围。
2020年更新
2020年对2019年版A&D章节的更新包括:(1)政府资助的异构集成项目的更新;(2)最新的相关市场数据;(3)A&D路线图表的0.1版本。填充和优化图10中的表将是2021年版HIR的重点。
异构集成的政府投资
DARPA的DAHI计划
美国政府,特别是国防高级研究计划局(DARPA)在异构集成方面的投资由来已久。图1显示了这些投资的时间表,这些投资通常集中于特定的应用和结构。最近的Diverse Accessible Heterogeneous Integration(DAHI)计划是一个很大的项目,展示了各种器件的异构集成,通过精细间距互连实现了突破性的性能和功能。图2显示了DAHI计划期间的进展。这项工作有助于形成HIR A&D工作的初步想法,DAHI和其他计划的指标表为制定路线图提供了非常有帮助的数据。

图1:DARPA在指导和投资异构集成方面有着悠久的历史[2]。
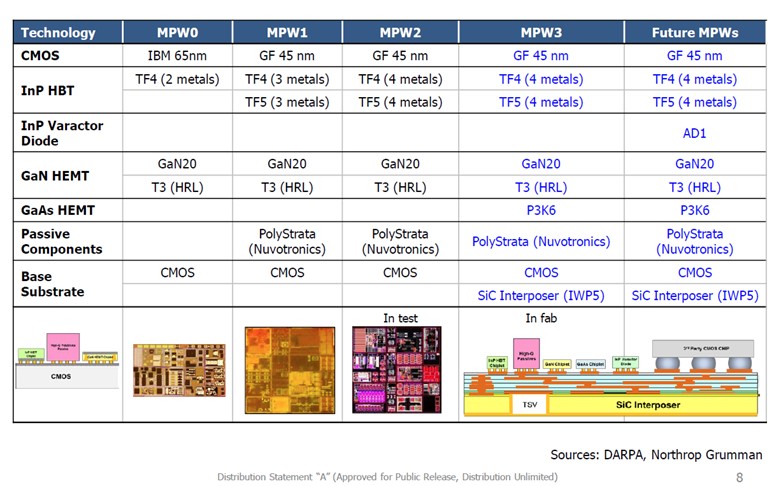
图2:DARPA的DAHI计划已经通过集成在CMOS硅中介板上的化合物半导体器件生产出越来越复杂的多项目晶圆(multi-project wafers ,简称MPW)[2]。
DARPA的芯片计划
继DAHI之后,DARPA的Common Heterogeneous Integration and Intellectual Property Reuse Strategies (CHIPS)
计划致力于建立标准接口,旨在使异构集成更加实用的“chiplet”生态系统中促进IP再利用。远景如图3所示,计划指标如图4所示。CHIPS的重要成果之一是由主要合同商Intel及其合作伙伴演示了Intel FPGA与先进的数据转换器、光学器件和其他芯片集成在一起,使用的是CHIPS计划中选择的接口标准Advanced Interface Bus (AIB)。

图3:DARPA的CHIPS计划展望了简化异构集成的chiplet生态系统[3]。

图4:CHIPS计划指标为HIR A&D路线图提供了非常有帮助的数据[3]。
说明:
- 通用IP的定义为商用供应商可供应的、或可共享的IP模块。
- 再利用的定义为现有的或以前设计的可再应用到目前系统中的IP模块。预先制造IP的定义为已经实体化的IP模块。
- IP有效资源必须是那些performer团队之外的资源。
- 各种硅工艺结,RF主动或半导体器件。
- 非重复性工程(NRE)费用和周转时间将与基准设计进行对比。
- 最小总线/延迟和数据速度应该可扩展至更高的数据数度
- 与chiplet之间传输数据有关的性能与基准设计进行对比。
CHIPS的成果之一是量化了基于中介板的异构集成制造要求,这是美国制造商或制造基础所缺乏的。图5和图6总结了这些要求以及如何为A&D应用考虑这些要求的远景。

图5:chiplet生态系统中基于中介板制造的CHIPS愿望清单[4]
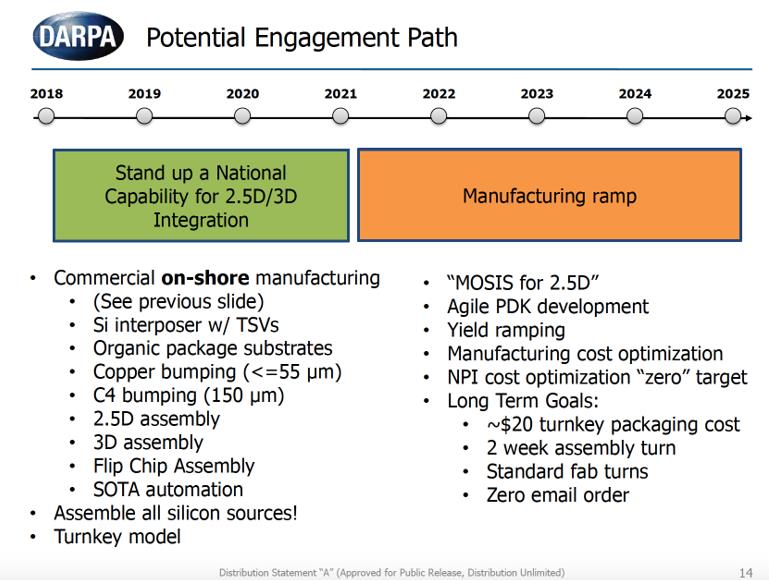
图6:CHIPS制造远景时间表[4]。
潜在实现路径
建立国家2.5D/3D集成能力
制造能力提高
- 商用境内制造
- 硅中介板w、TSV
- 有机封装载板
- 铜凸缘(<=55μm)
- C4凸缘(150μm)
- 2.5D组装
- 3D组装
- 倒装芯片组装
- SOTA自动化
- 组装所有硅芯片源
- 外包模式
- 2.5D MOSIS
- 灵活的PDK开发
- 良率升高
- 制造成本优化
- NPI成本优化“零”目标
- 长期目标:
- ~20美元外包成本
- 2周组装周转
- 标准制造周转
- 零邮件订单
NSWC的SHIP计划
如前所述,由于缺乏基于中介板的HI美国国内制造基地,Naval Surface Warfare Center(印第安纳州克雷恩)创建了State-of-the-art Heterogeneous Integrated Packaging(SHIP)计划。计划远景如图7所示,还列出了一些高级指标(图8)。该计划分为SHIP Digital和SHIP-RF,数字方面为第一阶段选择了Intel公司和Xilinx公司,为RF选择了Northrop Grumman公司、Qorvo公司、GE Research公司和Keysight Technologies公司。每个团队都制定了第一阶段的计划,为数字或射频应用建立自我持续的HI制造能力作为商业实体。政府愿意进行大型初始投资,且主要目标是使这种能力能够自我持续。我们希望在2021年版的HIR中包含关于继续执行SHIP计划的更新。

图7:SHIP计划将为异构集成创建安全的设计、组装和测试设施 [5]

图8:SHIP计划的高级指标对HIR A&D路线图非常有帮助。在SHIP征求意见稿 [5]中有更详细的指标。
新政府投资
值得注意的是,随着“美国CHIPS法案(CHIPS for America Act)”的出台,美国国内半导体制造业得到了显著的认可。这些激励措施和投资规模相当可观,约为250亿美元,很明显,重点是制造业。在图9的每个项目中都有明确的表述(图9)。美国还为高阶封装投资了50亿,用于成立National Manufacturing Institute。这正是HIR可以帮助确定行业发展所需的框架,我们希望在2021年探索这种合作。另外一点是DARPA、NSF、能源部和商务部的广泛投资。这表明,这些制造业的需求不仅仅是为了国防目的。电子产品的国家安全超越了传统的国防特定要求。

图9:美国政府对半导体制造业的拟议投资[6 & 7]。
HI路线图A&D状况
2019年版的HIR A&D章节提供了国防电子领域的HI前景,重点介绍了迄今为止推动了很多发展的政府项目。展望未来,A&D TWG将继续收集数据,并为2021年版本A&D章节添加内容。
图10是HIR A&D的第一个高级路线图表。目前它是定性的,而不是定量的,但我们希望随着我们深入探索更多细节,会逐步发展。此外,包含有关某些主题的更多细节还将链接到其他HIR章节,如光电学、热管理和3D互连。A&D TWG将致力于收集将在2021年更新的1.0版本输入数据。有兴趣参与这项工作的人可联系作者或波音公司的Tim Lee博士——A&D工作组的另一位联合主席。

图10: HIR A&D路线图的第一版(0.1版)在开始时是定性的。A&D TWG将收集数据充实2021年版的HIR。
References
1. IEEE Electronics Packaging Society, “Heterogeneous Integration Roadmap.”
2. Daniel Green, “DARPA’s CHIPS Program and Making Heterogeneous Integration Common,” 3D-ASIP 2017, December 2017.
3. Andreas Olofsson, “Common Heterogeneous Integration and Intellectual Property (IP) Reuse Strategies (CHIPS),” The Electronics Resurgence Initiative.
4. Andreas Olofsson, “2.5D/3D Foundry Workshop: CHIPS 2.0,” December 2018.
5. NSTXL, “State-of-the-Art Heterogeneous Integrated Packaging (SHIP) Prototype Project.”
6. Phil Garrou, “IFTLE 455: Advanced Microelectronics Is Coming Home,” 3DInCites.
7. 116th Congress, “R.7178 - CHIPS for America Act,” Congress.gov.
Jeff Demmin担任Keysight Technologies公司半导体和国防项目经理,同时担任HIR航空航天和国防技术工作组联合主席。


