在线路板制程领域,铜表面前处理贯穿了整个工艺流程,其中一个重要的环节就是为了增强铜面与各介电材料结合力而进行的铜面改善。因对5G全面商用的预期,目前业界正在寻找一种既不粗化铜面,又能增强铜层与介电材料良好结合力的新工艺,以达到高频信号在传输过程中无损耗的需求。
传统工艺中用于增强铜面与介电材料结合力的方法主要分为两类:第一类是采用超粗化、中粗化或者其它蚀刻类药水等化学方法,通过铜与酸在氧化剂的参与下在铜面上特定区域发生化学腐蚀,增大铜面的粗糙度,从而达到增强结合力的目的;第二类是通过磨刷、喷砂或者火山灰处理等物理方法来磨擦铜表面,增大粗糙度,使得铜层可以与上层的介电材料通过物理的铆合作用来达到紧密结合的效果。这些传统工艺除了会导致高频信号在传输过程中产生大量衰减以外,还伴有污染大(酸铜废水或者沙尘废水)、成本高(需额外预留1 mm ~3 mm铜厚,之后再把铜腐蚀掉或者打磨掉)、工艺复杂(化学法处理后须加酸洗段,物理法处理后须高压水洗或超声水洗)等缺点。正是为了避免这些缺点,近年来作为铜面与介电材料黏合的新工艺——键合剂越来越多地受到了业界的关注。键合剂是通过一个双官能团的小分子将铜层和介电材料黏合起来,该方法既不改变铜表面的粗糙度,也不会产生高铜高酸废水,同时更不需要在键合剂处理前预先留出待腐蚀或打磨的铜层,使用中也不会对铜面产生任何损伤。而在键合剂处理完之后,只需进行一般的水洗烘干即可进入后制程工序。此工艺可以直接在洁净铜面上使用,不必再进行任何铜面粗化处理。较之传统工艺的诸多弊端,键合剂工艺极大地缩短了工艺流程,降低了工艺成本,同时还能做到环保高效。
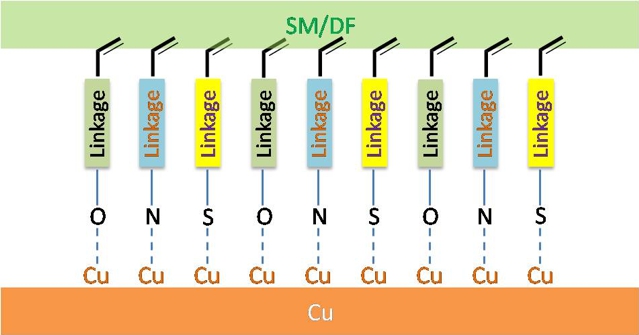
图1:键合剂作用原理示意图
键合剂分子是一类双官能团的小分子(见图1),在实际使用过程中扮演着链接剂的作用。键合剂分子以其中的一官能团通过配位键的方式与铜面上的铜原子紧密结合,在铜面上形成一层单分子膜,将另一官能团暴露在表面,通过后续的防焊喷涂、印刷或者干膜贴附,与介电材料中的单体或预聚物结合,在之后显影阶段发生聚合反应,将介电材料牢牢黏附在铜面上。与铜面结合力较好的化学结构一般包含氧、氮以及硫等原子,分子设计中会引入各种化学结构,包括羧基、酰胺基、脒基、唑基、磺酸基以及巯基等。而与介电材料中的单体或预聚物发生聚合反应则需要在键合剂分子中引入一系列不饱和基团,如双键、醛基以及环氧基等。分子设计中既要考虑官能团与铜面有足够的结合力来保证介电材料在铜面上的黏合强度,同时还要考虑显影段的弱碱可以完全祛除后续待处理铜面上的键合剂残留。若结合力不够,会出现掉油等防焊层问题,以及开路或缺口等干膜良率问题;若存在键合剂残留,会出现后处理OSP不上膜等防焊问题,以及残铜、短路等干膜良率问题。键合剂工艺的开发就是要通过合理的分子设计研制出适合各种介电材料与铜面黏合的键合剂产品,在不做任何铜面粗化的情况下达到与传统铜面粗化相同的工艺效果,同时不会因为键合剂残留而导致任何产品良率下降。
常规的键合剂工艺流程如图2所示。来料经酸洗除油之后,再由磨刷(或喷砂、火山灰处理)去除氧化物或钝化层。实际生产过程中视来料铜面的具体情况而定,如新制的铜面(例如新制电镀铜),可不经过任何除油磨刷处理,直接进入键合剂槽;内层铜箔或特殊板材的铜箔(软板材或特氟龙板材)只需酸洗无须磨刷即可保证产品品质。这些前处理的主要目的是为了保证在后续的键合剂处理过程中,有洁净的铜面裸露在外,以便与键合剂分子反应,从而保证牢固的结合强度。键合剂处理槽一般采用浸泡线或者低压喷淋线,药液与铜面接触后可在铜面上快速形成一层均匀的单分子膜,25℃反应30秒至60秒即可达到最佳成膜状态,继续延长反应时间无明显变化。键合剂处理后一般二级及以上水洗即可,无须使用酸洗或者高压超声水洗来保持铜面清洁,待烘干后就可以进入防焊或者干/湿膜工序。键合剂槽液中有效成分的浓度可由紫外分析和酸碱滴定的方法来管控,所以纵观整个生产流程,键合剂工艺的使用是非常简单且方便的,同时其废液可按一般酸性废液处理,不会产生传统工艺那样的废液废渣。

图 2:键合剂工艺流程
铜面经上述工艺处理后可在一般无尘环境中保留8小时。在8小时以内可直接进入防焊或者贴膜工序;若超过8小时或出现刮擦等其它问题,一般经显影槽处理后再回键合剂槽返工,可保证产品品质无影响。防焊层可通过静电喷涂或网印完成,经曝光显影后,进入后制程,包括化锡、化镍金以及OSP等表面处理。干膜或湿膜工序后制程一般包括蚀刻或电镀。蚀刻制程中重点检查残铜、开路以及缺口等因素导致的不良率;而电镀制程一般检查渗镀情况是否符合要求。
键合剂在弱酸性条件下可稳定吸附在铜面上,通过配位键与铜面结合,在碱性条件下又会快速解离,不造成残留,故而通过分子设计调节好键合剂的吸附强度,在前后制程配以适当的酸碱条件,可以非常容易实现键合剂在铜面上的吸附与脱附过程。根据配位原子的种类、个数以及相对位置,可以筛选出不同的键合剂材料,针对后续的耐物理作用或化学侵蚀的结合力测试,以及耐热冲击强度测试做出相应的调节。传统工艺中,即便是表现最好的超粗化,也缺乏类似的调整手段,除了改变蚀刻量,目前暂无非常有效的方法应对药水对防焊阻剂的侵蚀,具体表现为当表面处理完成后,常会发生防焊层的剥离,其原因在于化锡药水中含有硫脲的成份,其会攻击防焊层,以致造成防焊层的剥离。实际应用过程中发现,键合剂处理后制程如化锡或化镍金中的表现都是十分优越的,没有出现结合力不足而导致的防焊层脱落的情况。
业界有在粗化工序后、干膜工序前进行一段抗氧化处理的实施案例。一方面可以防止粗化后存放周期内铜面快速氧化造成的干膜工序良率下降;另一方面,一层有机抗氧化膜吸附在铜面上会在一定程度上提高干膜工序的良率。这其实可以理解为广义的“键合”效果。一般而言,树脂单体在不与铜面形成配位相互作用的情况下,结合力会相对比较弱,通过抗氧化层这样一个金属——有机物络合物可以在树脂与铜面之间形成一个过渡层,从而达到增强结合力的作用。此处的抗氧化层与干膜之间的作用仅仅只是类似于疏水相互作用或者是分子链之间的缠绕作用,其作用力并不强,而键合剂会在此基础上增加与干膜发生化学反应的基团,从而将干膜与键合剂之间的作用转变为化学键,其结合强度可以增加几十倍甚至上百倍。这样就可以保证干膜与铜面良好的结合力。而在显影工序中,键合剂分子会随着未曝光的干膜一起溶散在显影液中,不会在铜面上造成残留。
键合剂槽液使用寿命最高可达4周以上,生产周期内按照做板量进行常规添加即可,生产完毕,废液可按一般酸性废液处理。槽液中无金属离子,COD一般不超过1000 ppm,总氮含量不超过1 ppm,槽液中再无其它禁止排放或者管控物质检出。较之传统工艺废液中的金属离子或者沙尘废水,在当今环保形势日益严峻的大环境下,键合剂绝对是一款值得大力推广的环境友好型产品。除此之外,键合剂的环保优势还体现在与之相关的工序上,例如降低电镀槽以及蚀刻槽的作业量。传统工艺中,为了后续的粗化制程,一般会提前预留待蚀刻的铜层厚度(约1 mm ~3 mm)。据估算,单单1 mm厚的铜层加工(包括形成和腐蚀),其生产以及环保处理成本就可以达到每平方米0.5元以上。且一般线路板的制程中至少有三次铜面前处理,包括压合、干膜和防焊前都可以使用键合剂来代替传统工艺,所以使用键合剂前处理工艺对降低整个产业链的成本以及节能减排方面都起到了十分积极的作用。
目前键合剂应用已在各大线路板制造商中全面推开,市场上的产品也层出不穷,主要应用在防焊、湿膜以及干膜前处理工序上。防焊后处理集中应用于化锡、化镍金以及OSP等处理中。据市场反馈,键合剂的使用可明显提高产品良率,特别是针对一些特殊设计的部位,如阻焊桥、压环设计等。在传统工艺中,这些部位的防焊层比较薄,都是比较容易剥离的,键合剂的引入会明显改善这一现象。对于干膜后负片线路成型,键合剂处理工艺在残铜、短路、开路以及缺口等良率方面的问题较之传统工艺,也有明显改善,具体可参见表1(数据来自一年营收超20亿的大型线路板制造商,线宽为3 mil~4 mil的线路制作,因客户要求,公司名称及部分数据省去)。

表1:三种干膜前处理工艺的对比
综合上述,键合剂在目前绝大多数铜面前处理领域可以完全取代传统粗化工艺,其产品性能较之传统工艺也有了较大程度的提升。5G信号传输过程中的损耗问题以及环保等要求都会推动整个行业键合剂的使用需求,并且在防止打印油墨扩散等特殊问题解决过程中,键合剂的优势就显得更加明显。在实际使用过程中通过调节配方在铜面上形成一层疏水的键合剂膜,经证明,此层膜对防止打印油墨在铜面扩散起到了非常明显的抑制作用。此外对于超薄铜层或者超细线路等特殊制程,由于粗化及蚀刻工艺较高的微蚀量会导致品质问题,而键合剂则不存这方面的情况。在废水排放方面,目前的工艺改进也在持续进行中,业界已有采用铜粉吸附键合剂废液槽中老化组分的方式,过滤后通过分析补加有效成分用于继续生产,以此达到零废液排放的目的。

图3:键合剂在防焊以及干膜前处理工序中的表现
在过去的这一年里,键合剂工艺的研发和应用已在各大线路板厂全面展开,并在量产实绩中取得了十分理想的结果,真正做到了铜面无损的同时还能保持传统工艺的产品性能。新的环保形势以及5G信号传输对铜面粗糙度的要求使得各家供应商都在积极推广键合剂产品的使用,对产品性能和应用技术进行有效匹配。目前深圳市板明科技有限公司键合剂系列产品在干膜以及防焊前处理应用中已取得了媲美超粗化产品性能的实绩,且客户端的使用成本也远低于超粗化工艺,与中粗化工艺相当。所以键合剂产品必将因其独特的铜面无差损、环保以及成本低等性能,引领线路板制程中前处理工艺乃至更高阶的铜面与介电材料结合的应用,而传统的铜面处理技术会在高成本、铜面差损以及日趋严重的环保形势等因素的影响下逐渐走向衰退。
目前应用于防焊以及干、湿膜前处理键合剂产品已日趋成熟。防焊后处理包括了化锡、化镍金、化银、喷锡以及OSP处理等,产品性能优异。干膜前处理键合剂目前已有生产实际应用的主要集中在50 mm及以上线宽线路,其线路品质可媲美超粗化等传统工艺。对于线宽低于50 mm的精细线路,目前还未见键合剂的实施案例,这也是未来干膜前处理键合剂工艺的一个主攻方向。而压合前处理的键合剂目前还处于研发和试用阶段(市场上存在名称为压合前处理的“键合剂”产品,但其同样是广义上的键合剂,本质仍为棕化药水,没有直接证据证明其存在官能团与半固化片树脂层形成化学键),这主要是因为相对于防焊和干膜而言,半固化片的化学反应性能相对“惰性”而导致的。目前关于压合前处理键合剂的测试也在逐渐展开,相信不久的将来,键合剂产品一定会日趋完善,并逐渐取代传统工艺,成为铜面与介电材料黏合工艺的最佳解决方案。
夏海博士,2013年毕业于香港中文大学,主要从事有机电子材料方面的研究工作。同年入职香港应用科技研究院先进材料与封装部门任高级工程师。2015年起加入深圳市板明科技有限公司任研发经理,主要从事线路板制程前处理以及mSAP工艺专用化学品的研发工作。
标签:
#制造工艺与管理
#5G
#信号传输
#铜面与介电材料
#黏合新工艺
#键合剂
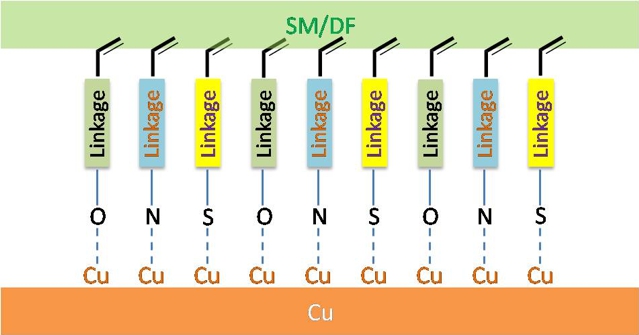
![]()




